應材強化異質整合優勢 推出新先進封裝解決方案
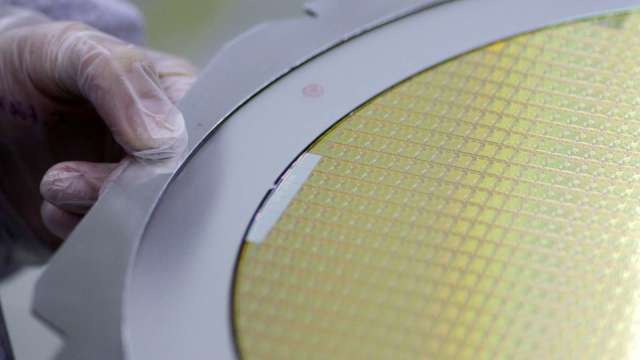
Tag
應材 (AMAT-US) 今 (13) 日宣布推出材料、技術新系統,將助晶片製造商運用混合鍵合、矽穿孔技術將小晶片整合至先進 2.5D、3D 封裝,擴大應材在異質整合 (HI) 領域領先業界的技術範疇。
應材表示,異質整合幫助半導體業者將各種功能、技術節點和尺寸的小晶片結合到先進封裝中,使組合後的整體能作為單一產品的形式來運作,將有助解決產業的挑戰。
應材指出,由於高效能運算、AI 等應用對電晶體需求指數級成長,傳統 2D 微縮速度趨緩且變得昂貴,異質整合使晶片商能以新方式改善晶片的功率、效能、單位面積成本與上市時間 (PPACt)。
應材是異質整合技術最大供應商,提供優化晶片製造系統,包括蝕刻 (ETCH)、物理氣相沉積 (PVD)、化學氣相沉積 (CVD)、電鍍 (ECD)、化學機械研磨 (CMP)、退火與表面處理。
應材半導體事業群副總 Sundar Ramamurthy 表示,異質整合技術正快速發展,最新解決方案推動產業新技術,可在 2.5D、3D 結構中封裝更多電晶體、導線。
應材表示,此次新方案包含 Insepra SiCN 沉積系統、Catalyst CMP,以及矽穿孔技術的 Producer InVia 2 CVD、Endura Ventura 2 PVD、Producer Avila PECVD。