AI GPU推動FOPLP發展 量產時間估2027-2028年
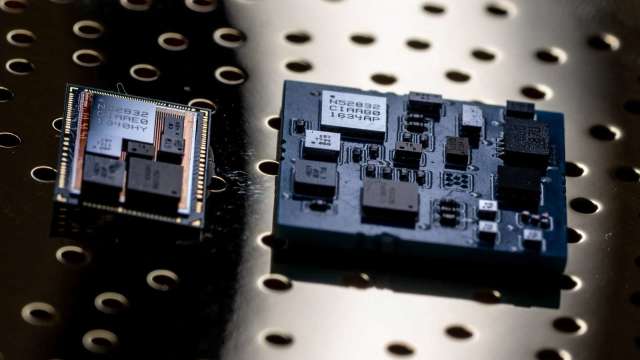
研究機構 TrendForce 今 (3) 日指出,台積電 (2330-TW)(TSM-US) 於 2016 年開發 InFO(整合扇出型封裝) 的 FOWLP(扇出型晶圓級封裝) 技術,並應用於 iPhone 7 手機搭載的 A10 處理器,封測廠也競相發展 FOWLP 及 FOPLP(扇出型面板級封裝) 技術,以提出單位成本更低的封裝解決方案。
TrendForce 認為,FOPLP 技術的優勢及劣勢、採用誘因及挑戰並存。主要優勢為低單位成本及大封裝尺寸,惟技術及設備體系尚待發展,技術商業化的進程存在高度不確定性,預估目前 FOPLP 封裝技術發展在消費性 IC 及 AI GPU 應用的量產時間點,可能分別落於 2024 年下半年至 2026 年,以及 2027-2028 年。
超微 (AMD-US) 等晶片業者自第二季起積極接洽台積電及封測業者,洽談以 FOPLP 技術進行晶片封裝,帶動業界對 FOPLP 技術的關注。據 TrendForce 調查,在 FOPLP 封裝技術導入上,三種主要模式包括「封測業者將消費性 IC 封裝方式自傳統封裝轉換至 FOPLP」;「晶圓代工廠與封測業者封裝 AI GPU,將 2.5D 封裝模式自晶圓級轉換至面板級」;「面板業者封裝消費性 IC」等三大方向。
從封測業者封裝消費性 IC,自傳統封裝轉換至 FOPLP 發展的合作案例來看,以 AMD 與力成 (6239-TW)、日月光投控 (3711-TW)(ASX-US) 洽談 PC CPU 產品,高通 (QCOM-US) 與日月光洽談電源管理 IC 產品為主。
以目前發展來看,由於 FOPLP 線寬及線距尚無法達到 FOWLP 的水準,因此 FOPLP 的應用暫時止步於 PMIC 等成熟製程、成本較敏感的產品,待技術成熟後才會導入到主流消費性 IC 產品。
若是觀察晶圓代工、封測業者封裝 AI GPU,將 2.5D 封裝模式自晶圓級轉換至面板級合作模式,以超微及輝達 (NVDA-US) 與台積電、矽品洽談 AI GPU 產品,在既有的 2.5D 模式下自晶圓級轉換至面板級,並放大晶片封裝尺寸最受矚目,惟由於技術的挑戰,晶圓廠與封測廠對此轉換尚處評估階段。
以面板業者封裝消費性 IC 為發展方向的則以恩智浦 (NXP) 及意法半導體 (STMicroelectronics) 與群創 (3481-TW) 洽談電源管理晶片產品為代表。
從 FOPLP 技術對封測產業發展的影響面來看,第一,封測業者可提供低成本的封裝解決方案,提升在既有消費性 IC 的市占,甚至跨入多晶片封裝、異質整合的業務。
第二,面板業者跨入半導體封裝業務;第三,晶圓廠及封測業者可壓低 2.5D 封裝模式的成本結構,甚至藉此進一步將 2.5D 封裝服務自既有的 AI GPU 市場推廣至消費性 IC 市場;第四,GPU 業者可擴大 AI GPU 的封裝尺寸。
鉅亨贏指標鉅亨贏指標是鉅亨網APP的訂閱服務,提供78種選股策略,幫助投資人決策個股短線多空操作。
了解更多鉅亨贏指標是鉅亨網APP的訂閱服務,提供78種選股策略,幫助投資人決策個股短線多空操作。
- 漲 627
- 跌 210
- 平 70
20,702.01
+155.52++0.76%
- 漲 560
- 跌 157
- 平 39
222.62
+3.07++1.40%
- 漲 320
- 跌 56
- 平 18
1,122.23
+11.33++1.02%
- 漲 21
- 跌 19
- 平 8
2,004.58
+2.53++0.13%
- 漲 330
- 跌 153
- 平 47
13,584.41
+26.88++0.20%













